专注于胶粘剂的研发制造
芯片胶是指PCBA制程工艺当中,在生产封装模式从DIP、QFP、PGA、BGA,到CSP/MCM的过程中围绕着芯片所必须应用胶水的统称。其种类有:贴片红胶、围堰填充胶、固晶胶、底部填充胶、COB邦定胶、防焊胶等。其中,芯片底部填充胶在场景运用中表现尤为重要,底部填充胶是一种用化学胶水(主要成份是环氧树脂),对BGA 封装模式的芯片进行封装模式的芯片进行底部填充,利用加热的固化形式,将BGA 底部空隙大面积填满,从而达到加固的目的,增强BGA 封装模式的芯片和PCBA 之间的抗跌落性能之间的抗跌落性能。

现今随着电子行业高精密、智能化的发展,BGA封装芯片在电子组装中应用越来越广泛,随之而来的则是BGA芯片容易因应力集中导致的可靠性质量隐患问题。那么,增强BGA组装机械可靠性的重要辅料‘底部填充胶’更为重要,选择底部填充胶的好坏对产品可靠性有很大影响。而实际应用中,不同企业由于生产工艺、产品使用环境等差异,对底部填充胶的各性能需求将存在一定的差异,如何选择适合自己产品的底部填充胶,研泰化学认为需重点关注以下几个方面。
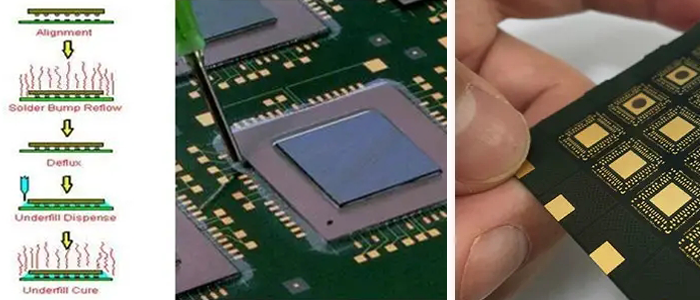
1 热膨胀系数(CTE)
焊点的寿命主要取决于芯片、PCB和底部填充胶之间的CTE匹配,理论上热循环应力是CTE、弹性模量E和温度变化的函数。但根据实验统计分析显示CTE1是主要的影响因素。由于CTE2与CTE1相关性很强,不管温度在Tg点以下还是Tg点以上,CTE2都会随着CTE1增加而增加,因此CTE2也是关键因素。
2 玻璃转化温度(Tg)
Tg在材料高CTE的情况下对热循环疲劳寿命没有明显的影响,但在CTE比较小的情况下对疲劳寿命则有一定影响,因为材料在Tg点以下温度和Tg点以上温度,CTE变化差异很大。实验表明,在低CTE情况下,Tg越高热循环疲劳寿命越长。

3 流动性
底部填充胶应用原理是利用毛细作用使得胶水迅速流过BGA /PCB芯片底部芯片底部,其毛细流动的至小空间是10um。根据毛细作用原理,不同间隙高度和流动路径,流动时间也不同,因此不同的填充间隙和填充路径所需填充时间不同,从而容易产生“填充空洞”。
为更直观的评估胶水流动性能,可采用以下方法评估胶水流动性:将刻有不同刻度的载玻片叠在PCB板的上方,中间使用50um的垫纸,使载玻片与PCB间留有间隙,在载玻片一端点一定量胶水,测试胶水流动不同长度所需的时间。由于胶水流动性将随温度变化而变化,因此,此实验可在加热平台上进行,通过设置不同温度,测试不同温度下胶水流动性。

4 与锡膏兼容性
底部填充胶起到密封保护加固作用的前提是胶水已经固化,而焊点周围有锡膏中的助焊剂残留,如果底部填充胶与残留的助焊剂不兼容,导致底部填充胶无法有效固化,那么底部填充胶也就起不到相应的作用了,因此,底部填充胶与锡膏是否兼容,是底部填充胶选择与评估时需要重点关注的项目。
5 绝缘电阻
底部填充胶除起加固作用外,还有防止湿气、离子迁移的作用,因此绝缘电阻也是底部填充胶需考虑的一个性能。
6 长期可靠性
底部填充胶主要的作用就是解决BGA/CSP芯片与PCB之间的热应力、机械应力集中的问题,因此对底部填充胶而言,很重要的可靠性试验是温度循环实验和跌落可靠性实验。

针对底部填充胶需求运用的重要性,研泰化学推出了一款芯片专用底部填充胶MX-6278 ,MX-6278单组分、低粘度自流平、流动性好、可返工的底部填充环氧树脂,适用于CSP(FBGA)以及BGA。加热至130度9分钟快速固化,抗机械应力出色,低粘度树脂可充分的填充CSP(FBGA)芯片底部以及BGA晶片焊点保护。用于CSP、BGA、WLCSP、LGA以及其它类型设备时,提供卓越的加工性能,具有高可靠性、室温流动性、可返工性和优异表面绝缘抗阻性能的解決方案,配方设计可降低由不同膨胀系数导致的应力水准,在热循环、热冲击、跌落实验和其它必要实验及实际使用中稳定性卓越。
研泰化学致力于为企业客户提供技术先进的材料解决方案,通过为客户解决材料需求来创造最大化价值。如果您对底部填充胶还有疑问,随时敬候您的垂询,或您也可将遇到的问题及困惑通过留言的形式反馈给我们,研泰化学胶粘剂精益求精十余载,强于开发,精于制造,专注芯片底部填充胶的研究,为您提供定制化的底部填充胶应用解决方案。